新型多觸發極紫外光刻膠材料
近年來,極紫外(EUV)光刻一直被認為是下一個可行的光刻方案。然而,在光學系統、掩膜版、光刻膠材料等方面的技術難題阻礙了這一技術的應用。例如,EUV光掩膜系統已經由原來的透射式改為反射式,這已經被證明是一個很有挑戰性的過渡,目前EUV scanner的出貨正在加速。同時,EUV掩膜以及解決缺陷問題需要用到的薄膜正在研發中。
為了滿足EUV對光刻膠的要求,光刻膠廠家最初通過調整光刻膠配方、添加劑、PAG對現在的193nm光刻膠進行重新計算,以適用于EUV。雖然這是一個符合成本效益的方法,但這樣一來限制了線寬粗糙度(LWR)、靈敏度以及分辨率。LWR是通過圖形沿長度方向寬度的隨機變化定義的。隨著光刻圖形尺寸越來越小,圖形側壁的缺陷成為了圖形誤差的一大來源。此外,根據先前的研究結果,高LWR已歸因于聚合物的使用。其他影響LER值的因素有散射噪聲、PAG位置、酸擴散以及顯影液的選擇。幾乎沒有商用材料可以保證LWR在3nm以下,所以更高靈敏度的光刻膠有待開發。
大約在3年前,光刻膠用戶開始推廣新的光刻膠——分子光刻膠(Molecular resists)。因此目前分子光刻膠已經專注于解決聚合物尺寸、多分散性以及濃度的問題。與傳統的基于聚合物的光刻膠懸浮液不同,分子膠的配方是以小分子為基礎的。有很多分子系統正在被用于此項研究,位于Irresistible Materials的團隊已經研發出一種新材料——多觸發光刻膠(multitrigger resist),這是化學放大分子光刻膠的一大進展,借此可以實現高分辨率、高靈敏度、低LWR。
在現有的多觸發材料中,光刻膠的曝光過程引入了催化反應,類似于化學放大膠,如圖1(a)所示。然而,與一個光酸分子會引起一次曝光不同,本文采用多個光敏劑(photoinitiators)激發多個光敏感分子。然后這些分子相互反應完成一次光刻膠曝光,同時產生光敏劑(photoinitiators)。在大量激活的光敏劑(photoinitiators)區域(如一個圖形中間的高劑量區域),被激活的光刻膠成分距離很近,如圖1(b)所示。連續多次發生的光刻膠反應可以過得較高的對比度。相反,對于只有一小部分光敏劑(photoinitiators)被激活的區域(如一個圖形邊緣的低劑量區域),被激活的光刻膠成分距離較遠以致很難發生反應,如圖1(c)所示。隨著激活光敏劑(photoinitiators)被移除之后催化反應停止。利用這種方法,本文的多觸發機制使得圖形邊緣處的化學梯度增加,同時減小酸的擴散。

圖1 (a)應用于極紫外光刻的傳統化學放大膠的機理;(b)高劑量區域的多觸發機制;(c)低劑量區域的多觸發機制
在接觸通圖形上驗證了多觸發光刻膠,如圖2所示。實驗采用的勞倫斯伯克利國家實驗室(Lawrence Berkeley National Laboratory)的微場曝光工具(MicrofieldExposure Tool)。該工具是目前分辨率最高的極紫外光刻工具(數值孔徑為0.3)。其中,曝光劑量小于20mJ/cm2,通孔圖形中最小的關鍵尺寸為25nm。
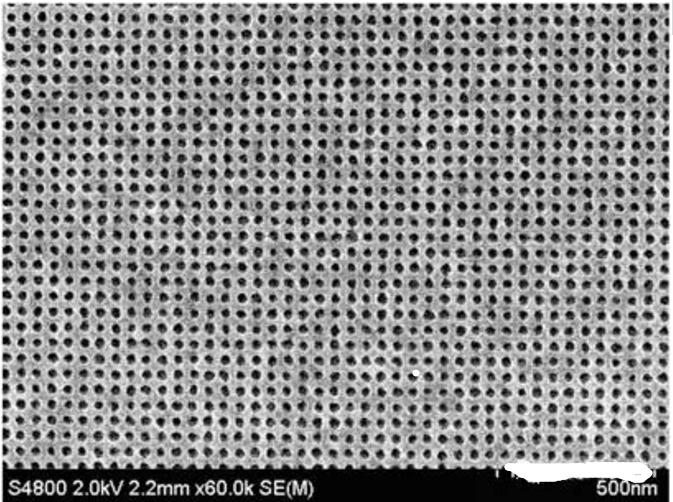
圖2 25nm半周期接觸孔的SEM圖片。該圖形由勞倫斯伯克利國家實驗室(Lawrence Berkeley National Laboratory)的微場曝光工具(MicrofieldExposure Tool)獲得,曝光劑量為17.6mJ/cm2。
與傳統技術相比,該多觸發系統有很多優勢。例如,采用該系統,不需要進行后烘工序(這點與大多數化學放大光刻膠系統不同),這進一步縮短了工序周期。另一個優勢是,該光刻膠是有機的,這意味著可以利用現成的金屬還原技術和刻蝕工藝。使用現有的刻蝕工序不需要進行昂貴且漫長的新的刻蝕工藝的研發。
與現有光刻膠系統(即基于化學放大的光刻膠系統)相比,有低成本、高感光速度,和高分辨率的好處和優勢。該光刻膠是非金屬的,且適用于批量生產。
汶顥微流控技術公司提供芯片相關實驗室配件耗材。光刻膠系列有進口Microchem SU8光刻膠、AZ 光刻膠、顯影液、正性光刻膠、負性光刻膠及光刻膠去膠液等相關耗材。歡迎來電咨詢光刻膠價格。咨詢電話:181-3677-3235
標簽: 光刻膠材料 紫外光刻

