光刻工藝的評價標準
一個集成電路的制造過程(process flow)是由許多工藝單元(unit process)構成的,每一個工藝單元的輸出就是下一個工藝單元的輸入。工藝單元之間的銜接和整合是由工藝集成(process integrated,PI)部門負責的。光刻工藝的輸出就是光刻膠上的圖形。一般集成部門對光刻膠上的圖形有嚴格要求。如圖所示:
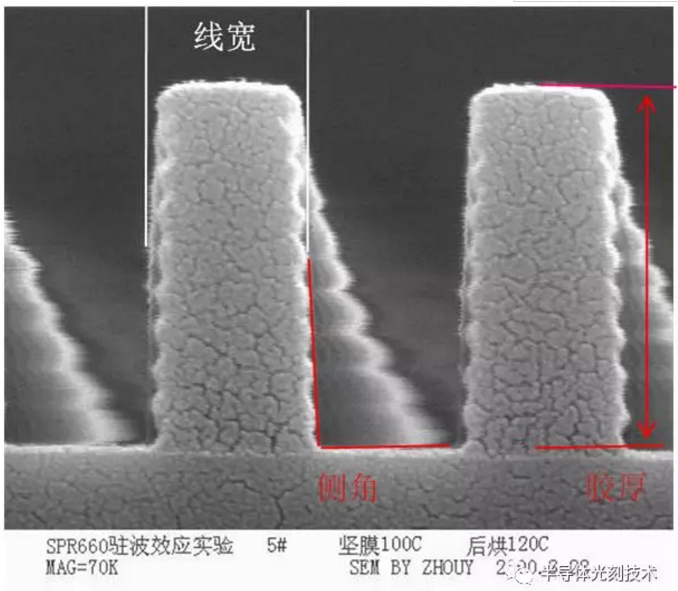
首先是圖形的線寬,一般是在目標值的±(8-10)%之內。其次是套刻誤差,光刻膠上的圖形必須與襯底上的參考層對準,如圖所示:
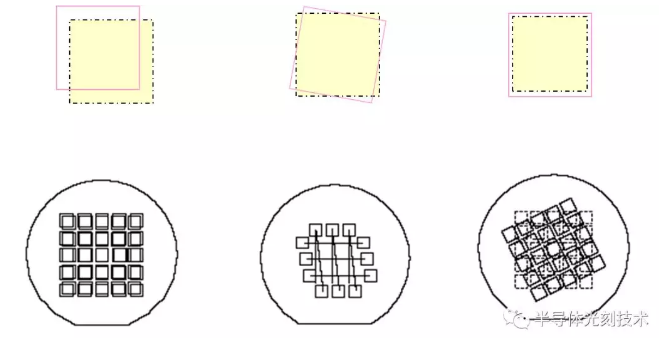
其X/Y方向的偏差必須小于一個規定的值。通過KrF光刻能達到小于±15nm的套刻誤差,ArF光刻能達到小于±7nm的套刻誤差。第三,晶圓表面膠的厚度。光刻后的下一道工序通常是反應離子刻蝕(reactive ion etch,RIE)。盡管反應離子刻蝕有很高的選擇性,但光刻膠必須有一定的厚度才能保證在刻蝕的過程中不被全部消耗掉。第四,光刻膠剖面側角(side wall angle)必須大于85度。
隨著技術節點的縮小,即線寬的縮小,對晶圓上線寬均勻性(CDU)和套刻誤差的要求也相應地提高。ITRS曾經建議,CDU(3δ)必須不能超過線寬的7%,套刻誤差不能大于線寬的20%。對于20nm半周期節點,CDU必須小于1.4nm,套刻誤差必須小于4nm。
集成電路生產廠光刻工程師的職責就是要保證光刻后光刻膠上的圖形符合以上各項要求。為了實現這個目標,光刻工藝中的各項參數都必須控制在一個較小的范圍,被稱為工藝窗口(process window)。光刻工藝的窗口一般是通過曝光聚焦-能量矩陣(focus-energy matrix,FEM)數據來確定的。曝光時,在一個方向以固定的步長改變聚焦值,另一個方向以另一個固定的步長改變曝光能量,如圖所示。曝光顯影完成后,測量晶圓上圖形的尺寸,得到所謂的“bossung”圖,假設所要的圖形的目標線寬(target CD)是56nm,允許的范圍是±3nm(在圖中用方框標出),那么在曝光能量等于17.6mJ/cm2時的焦深大約就是100nm。
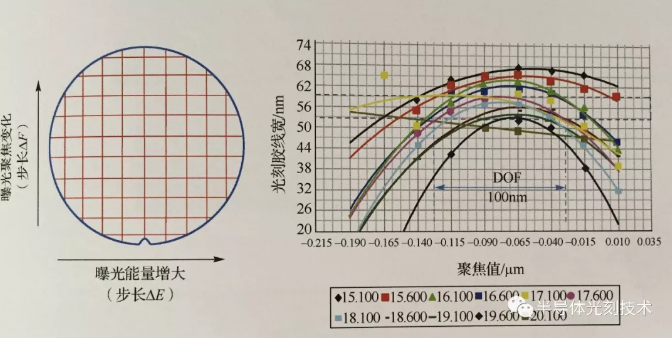
聚焦-能量矩陣曝光設置以及關鍵線寬隨曝光能量和聚焦值的變化曲線-----“Bossung”圖(圖中能量的單位是mJ/cm2)
(文章來源:半導體光刻技術 轉載僅供參考學習及傳遞有用信息,版權歸原作者所有,如侵犯權益,請聯系刪除)

